概要
AIブームが続く中、TSMCが1.3nmプロセス技術開発を進めるとともに、2029年までにアリゾナ州に先端チップパッケージング工場を開設する計画を発表しました。これはCoWoSおよび3D-ICの生産能力を拡大し、AIチップの供給ボトルネックを緩和し、米国の半導体サプライチェーンを強化する狙いがあります。SKハイニックスのAI半導体販売好調も報じられています。
詳細
AIブームが継続する中で、半導体業界の主要な動きとして、TSMCが1.3nmプロセス技術の開発に取り組んでいることや、Appleの次期CEO発表が報じられました。特に注目されるのは、TSMCがCoWoSおよび3D-ICの生産能力を拡大するため、2029年までにアリゾナ州に先端チップパッケージング工場を開設する計画です。この戦略は、台湾で行われているパッケージング作業を米国顧客により近い場所で行うことで、AIチップの供給におけるボトルネックを緩和することを目的としています。また、米国でのパッケージング拠点増設により、台湾での最終工程を省略する可能性も示唆されており、米国の半導体サプライチェーン強化への動きが加速していることが明確に示されています。記事では、SKハイニックスのAI半導体販売による好調な業績も併せて報じられ、AI関連半導体市場の活況が浮き彫りになっています。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQEC0Fr3-yDvN







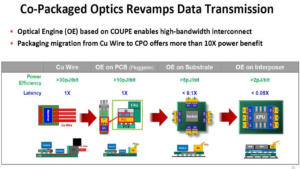

コメント