2026年3月4日に開催された「2026 PCB展望×先進パッケージングシンポジウム」では、TGVやFOPLPなどの先端技術開発に焦点が当てられた。ASEは、AI/HPC需要がパネルレベルパッケージング(PLP)を加速させていると指摘し、PLPのグローバル標準化を推進。経済部産業発展署は、高階設備への依存を減らし、国内企業の自主開発能力を強化するための補助金計画を打ち出す予定。
経済部産業発展署主催、金属工業研究発展中心承辦、台湾電路板協会(TPCA)実行の「2026 PCB眺望×先進パッケージングシンポジウム」が2026年3月4日に開催され、約160名の業界関係者が参加した。本シンポジウムでは、TGV(Through Glass Via)やFOPLP(Fan-Out Panel-Level Packaging)などの前瞻技術開発に焦点が当てられた。日月光(ASE)の楊秉豐研究開発処長は、AIとHPCがパッケージング需要をパネルレベルパッケージング(PLP)へと加速させていると指摘。600mmパネルの生産効率は12インチウェーハの約5.5倍だが、大サイズ化に伴う翹曲制御や均一性などの課題がある。日月光は日本および北米と協力し、PLPのグローバル標準化を推進しており、2026年の標準アーキテクチャ完成を目指している。また、経済部産業発展署は3月末までに、高階設備への依存を減らし、国内企業の自主開発能力を強化するための補助金計画を打ち出す予定である。このシンポジウムは、台湾が次世代パッケージング技術開発において、産官学連携で主導的な役割を果たそうとしている姿勢を示している。
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQHU6YmDX90Oi






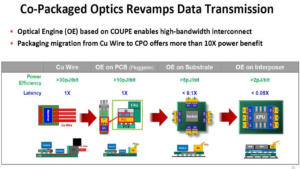


コメント