FOPLPは、AIや5G需要によるチップサイズ拡大に対応する将来の先進パッケージング主流技術となる可能性を秘める。世界のFOPLP市場は年平均成長率29%で約29億ドル規模に達すると予測。当面はPMICや中低価格RF部品など成熟プロセス製品への応用が中心だが、2027-2028年には大型AI GPUなどのハイエンドアプリケーションでの量産も期待される。将来的にはガラス基板技術との組み合わせで、歩留まりと相互接続密度が向上する。
FOPLP(Fan-Out Panel-Level Packaging)は、AIや5Gなどの需要によりチップサイズが拡大する中、将来の先進パッケージングの新たな主流となる可能性を秘めている。市場調査機関DSCCは、ガラス基板パッケージングを含む世界のFOPLP市場が年平均成長率29%で成長し、約29億ドル規模に達すると予測している。現在、FOPLPの線幅・線間隔は最先端のFOWLP/CoWoSには及ばないため、当面は電源管理IC(PMIC)や中低価格帯のRF部品など、成熟プロセスでコストに敏感な製品への応用が中心となる。2024年下半期から2026年にかけて、これらの消費性ICのFOPLPパッケージングが徐々に量産される見込みである。大型AI GPUなどのハイエンドアプリケーションでは、2027年から2028年にかけて量産が開始される可能性がある。将来的には、FOPLPはガラス基板技術と組み合わされ、ガラス材料の低熱膨張と高寸法安定性の特性を活用して、歩留まりと相互接続密度をさらに向上させる可能性がある。ASEのような主要OSAT企業もこの技術に注目し、投資を加速している。
関連企業:
技術キーワード:
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQHOcSk4MmbNv







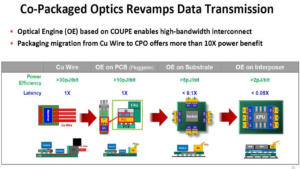

コメント