概要
半導体パッケージング・テスティング世界最大手の台湾ASEは、先進パッケージングの需要拡大を受け、2026年の設備投資を1兆3300億円規模に上方修正すると発表した。これはAI半導体市場の成長と高密度実装技術への需要増に対応するため。関連ニュースとして、Powertech Technologyが2026年下期にFOPLPの検証を開始する予定。
詳細
半導体パッケージング・テスティング(封止・検査)の世界最大手である台湾・日月光投資控股(ASEテクノロジー・ホールディング、ASEH)は2026年4月29日、先進パッケージングの需要拡大に対応するため、2026年の設備投資計画を上方修正し、1兆3300億円規模とすることを発表した。この大規模な投資は、AI半導体市場の爆発的な成長と、それに伴う高密度実装技術への需要増に対応するための戦略的な動きである。ASEHは、AIチップの性能向上に不可欠な先端パッケージング技術の供給能力を強化することで、市場における主導的地位を維持・拡大することを目指している。また、関連ニュースとして、台湾力成(Powertech Technology)が2026年下期にFOPLP(Fan-Out Panel Level Packaging)の検証を開始する予定であることも報じられており、台湾のOSAT業界全体で次世代パッケージング技術への投資が加速している状況が伺える。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQHa4O32bISOv







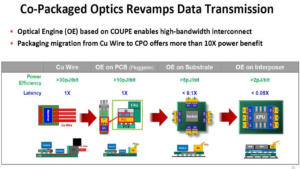

コメント