概要
半導体後工程において、パネル・レベル・パッケージ(PLP)が注目されている。PLPは、従来のウェーハレベルパッケージングより大きな方形基板を使用し、生産効率とコスト削減を実現。チップレット技術との組み合わせで、歩留まり向上と高性能化を両立できる。日本のTOWAは、PLP対応のコンプレッション型モールディング装置「CMPシリーズ」などを手掛ける大手メーカー。
詳細
半導体後工程において、パネル・レベル・パッケージ(PLP)が注目されている。PLPは、従来のウェーハレベルパッケージングよりも大きな方形の基板を使用することで、生産効率とコスト削減を実現する技術である。特に、チップレット技術との組み合わせにより、大規模な回路を小さなチップ(ダイ)に個片化し、複数のチップレットを単一のパッケージに集積することで、歩留まりの向上と高性能化を両立できる。この技術は、AIやHPCといった高性能半導体の需要増に対応するための重要なソリューションとして期待されている。日本のTOWAは、封止(モールディング)や切断(シンギュレーション)加工など半導体製造後工程用製造装置の大手メーカーであり、320mm×320mmまでのPLPに対応したコンプレッション(圧縮成形)型モールディング装置「CMPシリーズ」などを手掛けている。PLPの普及は、後工程装置メーカーにとって新たなビジネスチャンスを生み出すと同時に、半導体サプライチェーン全体の効率化に貢献する。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQFtRLkDyu4bE







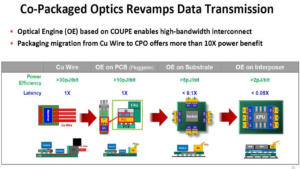

コメント