概要
半導体の後工程において、高性能パッケージを効率的に製造する「パネル・レベル・パッケージ(PLP)」が注目されています。チップレット集積パッケージのタイムリーな提供に不可欠であり、RDL多層化に伴う基板の反り対策が課題です。SCREENホールディングスの塗布・乾燥装置「Lemotia」やTOWAのモールディング装置など、日本の装置メーカーがPLP対応技術を開発しています。
詳細
半導体の後工程において、高性能な半導体パッケージを「安く・早く・大量に」製造できる革新的な手法として、「パネル・レベル・パッケージ(PLP)」が大きな注目を集めています。PLPは、チップレット集積パッケージなどをタイムリーに市場に提供する上で極めて重要であり、その普及が期待されています。しかし、RDL(再配線層)の多層化に伴う基板の「反り」への対応が、歩留まり改善における主要な課題として指摘されています。このような技術的課題に対し、日本の装置メーカーが積極的にソリューションを提供しています。具体的には、SCREENホールディングスが先端パッケージ専用の塗布・乾燥装置「Lemotia」を開発し、PLP基板やガラスコア・サブストレートに対応していること、またTOWAがPLP対応のモールディング装置を手掛けていることなどが紹介されています。これらの技術革新は、後工程材料や装置の進化が、先端パッケージング技術の広範な普及と性能向上に不可欠であることを明確に示しており、日本の技術力がこの分野で重要な役割を果たすことが期待されます。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQF8f71ortqBB







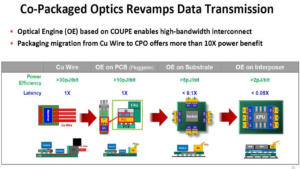

コメント