京セラは、AIデータセンター向け先端半導体パッケージ用の多層セラミックコア基板の開発を発表した。高密度配線と基板剛性に優れた独自のセラミック材料を活用し、実装時の反り低減を実現。生成AI普及によるパッケージ基板の大型化・高密度化で有機コア基板の課題が顕在化する中、京セラは積層セラミックパッケージ技術を応用し、高剛性と微細配線を両立する。この開発品はECTC2026で展示予定で、日本の材料メーカーが先端パッケージングのボトルネック解消に貢献する重要な技術となる。
京セラ株式会社は2026年4月27日、AIデータセンターの高度化に伴い大型化が進むxPUやスイッチASICなどの先端半導体パッケージ向けに、多層セラミックコア基板の商用化に向けた開発を進めていることを発表した。この基板は、高密度配線が可能で基板剛性に優れた独自のセラミック材料を活用することで、先端半導体パッケージ実装時の反りの低減を実現する。特に、生成AIや大規模言語モデル(LLM)の普及により、2.5Dパッケージ型を中心にパッケージ基板の大型化・高密度配線化が加速する中で、有機コア基板では剛性不足による反りや配線微細化が課題となっていた。京セラは、積層セラミックパッケージで培った材料・コア技術を活かし、高剛性と微細配線を両立する多層セラミックコア基板を開発。この開発品は、2026年5月26日~29日に米国オーランドで開催される半導体パッケージング技術の国際学会「ECTC2026」にて展示される予定。日本の材料メーカーが、先端パッケージングのボトルネックを解消し、次世代AI/HPC向け半導体の性能向上に貢献する重要な技術を提供しようとしている。
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQGO2ZQG4wewr
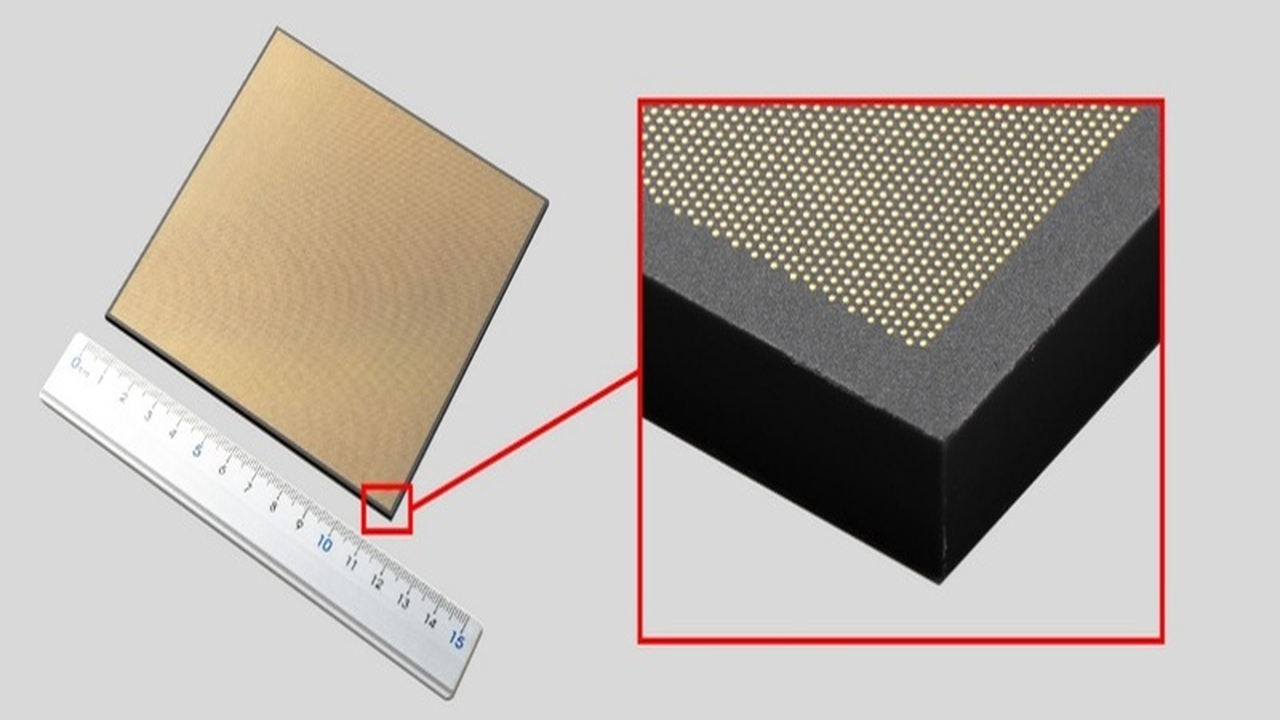






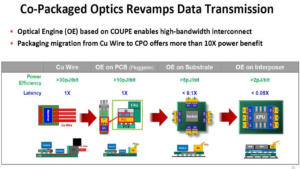

コメント