富士フイルムは、先端半導体の前工程と後工程の両方で新材料開発・量産に注力している。銀塩フィルム技術を応用し、EUV露光用レジストや現像液といった前工程材料に加え、先端パッケージングにおけるポリイミド材料に注力。ポリイミドはインターポーザやビルドアップ基板の材料として、2.5D/3D実装やチップレット技術に不可欠。日本の材料メーカーが半導体製造のボトルネックを解消し、先端パッケージングの性能向上に貢献する強い意志を示している。
富士フイルムが、先端半導体の前工程と後工程の両方で新材料の開発・量産に注力していることが、2026年4月30日の記事で報じられた。同社は、長年培ってきた銀塩フィルムの技術を応用し、フォトレジストのような光感光性材料だけでなく、インターポーザやビルドアップ基板の材料として機能性ポリマーであるポリイミド樹脂を最大限に活用し、新たな半導体製造プロセスに活かしている。特に、EUV(極端紫外線)露光用のレジストや現像液といった前工程材料に加え、先端パッケージングにおけるポリイミド材料への注力は、後工程技術の進化に不可欠な要素である。インターポーザやビルドアップ基板は、2.5D/3D実装やチップレット技術において、複数のチップを接続するための重要な基盤となる。富士フイルムのこの戦略は、日本の材料メーカーが、半導体製造のボトルネックを解消し、先端パッケージングの性能向上に貢献しようとする強い意志を示している。これは、日本の材料産業が、半導体サプライチェーンにおける高付加価値分野での競争力を強化する具体的な動きである。
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQGJOFnQBtqWk







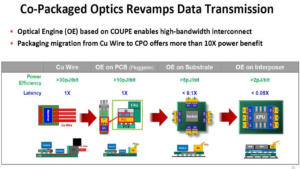

コメント