概要
TSMCは、2026年末までにCoWoSウェーハの月産能力を13万枚に拡大する計画を決定した。これは2024年末の約4倍に相当し、生成AIや大規模データセンターのハードウェアボトルネック解消を目指す。CoWoSはGPUやHBMを統合する2.5D/3Dパッケージング技術であり、特にCoWoS-Lの生産を強化し、巨大ダイの接続に対応する。
詳細
TSMCは、2026年末までにCoWoS(Chip-on-Wafer-on-Substrate)ウェーハの月産能力を13万枚に達する計画を最終決定した。これは2024年末の生産量から約4倍に相当する大幅な拡大であり、生成AIや大規模データセンターの展開を制約してきたハードウェアのボトルネックを解消することを目的としている。CoWoSは、GPUやHBM(高帯域幅メモリ)などの複数のシリコンダイを単一のインターポーザー上に統合する2.5Dおよび3Dパッケージング技術であり、AIハードウェアの次世代において不可欠な技術となっている。特に、TSMCはCoWoS-Lの生産を強化しており、これは単一のリソグラフィ露光の物理的限界を超える巨大なダイを接続するために使用される。この積極的な生産能力増強は、AI半導体市場の急成長に対応し、TSMCがその技術的優位性と市場シェアを維持するための重要な戦略である。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQFTXnLYdZSf-







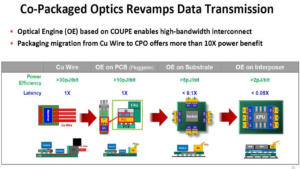

コメント