概要
2026年には先端パッケージングが半導体パッケージング市場の60%以上を占めると予測されています。ムーアの法則の限界に直面する中、ハイブリッドボンディングピッチ、チップレットの相互運用性、インターポーザーサプライチェーンが競争の鍵です。Intelは米国ニューメキシコ州に施設を運営し、TSMCやSamsungと共に主要特許を保有。AIサーバー需要とチップレット採用が市場成長を牽引し、2027年までに市場は650億ドルに達する見込みです。
詳細
この記事は、2026年の先端パッケージング技術の展望を詳細に分析しており、先端パッケージングが半導体パッケージング市場全体の60%以上を占めるようになると予測しています。ムーアの法則の限界に直面する中で、先端パッケージングが半導体性能向上の主要な手段となっていることが強調されています。特に、ハイブリッドボンディングピッチ、チップレットの相互運用性標準、インターポーザーサプライチェーンの支配が、今後の競争における鍵となると指摘されています。Intelは米国ニューメキシコ州に先端パッケージング施設を運営しており、TSMCやSamsungとともにこの分野で主要な特許を保有しているとされています。AIサーバーの需要とチップレットの採用が市場成長の主要な推進力であり、2027年までに世界の先端パッケージング市場は650億ドルに達すると予測されており、この技術が半導体産業の未来を形作る上で不可欠な要素であることが示されています。
関連情報
元記事: https://vertexaisearch.cloud.google.com/grounding-api-redirect/AUZIYQHBTeC2MXvOv







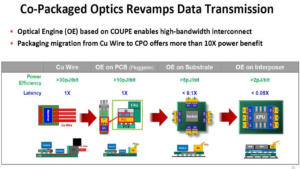

コメント