背景
AIや高性能コンピューティング(HPC)の進化に伴い、半導体パッケージング技術は飛躍的な進歩が求められている。従来のワイヤーボンディングやフリップチップ技術では対応が難しい、さらなる高密度化、高帯域幅化、低消費電力化を実現するため、ハイブリッドボンディングやCo-Packaged Optics(CPO)のような先端技術が不可欠となっている。
主要内容
オランダを拠点とするBEセミコンダクター(Besi)は、2026年第1四半期の決算発表において、ハイブリッドボンディング技術の採用が急速に進んでいることを主要な戦略的推進力として強調した。同社の受注は前年同期比で105%も急増しており、この需要の高まりは、特にAIアプリケーション向けのウェーハレベル組立が牽引していると分析されている。ウェーハレベル組立は、高い帯域幅、低い消費電力、そして優れた熱管理能力を提供することで、従来のパッケージング手法と比較して顕著な優位性を持つ。レポートでは、韓国のSamsung Electronicsが次世代の高帯域幅メモリ(HBM)向けにハイブリッドボンディングの導入を拡大していること、さらに2030年までにCo-Packaged Optics(CPO)技術の実現を目指すシリコンフォトニクスファウンドリサービスを開始したことが報じられた。これを受けて、BEセミコンダクターは、台湾と韓国におけるサービスおよびサポート体制の増強を進めている。経営陣は、AI用途の拡大、主流アプリケーションの回復、新しいファブの稼働、そして広範な先端パッケージング技術の採用が、組立装置市場の成長を促進すると予測しており、2025年の52億ドルから2030年までに91億ドルへと市場が拡大すると見込んでいる。
影響と展望
BEセミコンダクターの好調な業績と今後の見通しは、先端パッケージング技術、特にハイブリッドボンディングとシリコンフォトニクスが半導体産業の成長を牽引する中核技術となっていることを明確に示している。Samsungのような大手メーカーがCPOへのコミットメントを明確にしたことは、光電融合技術の商業化が加速する兆候であり、データセンターやHPC市場における光通信技術の重要性が一段と高まることを意味する。AIアプリケーションの普及に伴い、半導体装置メーカーは、より複雑で精密な組立技術を提供することが求められ、関連する材料メーカーや光デバイスベンダーにとっても大きなビジネスチャンスが生まれる。この技術革新は、将来のデジタルインフラの効率と性能を根本的に向上させるだろう。
元記事: https://jp.investing.com/news/company-news/article-93CH-1502938







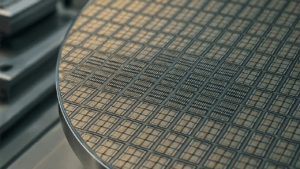

コメント