高密度ファンアウト(HDFO)技術の重要性
Amkor Technologyは、標準的なファンアウトとハイエンド2.5Dシリコンインターポーザーソリューションの間のギャップを埋めるように設計されたプラットフォームである、高密度ファンアウト(HDFO)パッケージング技術を積極的にスケールアップしています。HDFOは、高価なシリコンインターポーザーを必要とせずに、微細配線再配線層(RDL)を使用して複数のダイ(チップレット)を接続し、特定のAIおよびHPCアプリケーション向けにより費用対効果の高いソリューションを提供します。これにより、高性能とコスト効率のバランスを求める顧客にとって、魅力的な選択肢となっています。
Amkorの生産能力拡大と市場需要
報告によると、複数のHDFOプログラムがAIデータセンターおよびPCデバイス顧客からの需要に牽引され、大量生産段階にあるか、最終的な認定に近づいています。この成長を支えるため、Amkorは製造拠点を拡大しています。同社は韓国の施設でHDFO容量を増強し、同時に低複雑度の消費者向けパッケージングラインをベトナムに移管しています。この戦略的な再編成により、韓国のプレミアムクリーンルームスペースが高価値の先進パッケージング向けに解放されます。これにより、Amkorは増加する需要に柔軟に対応し、市場における競争力を維持・強化することが可能になります。
チップレットパッケージングの多様化とHDFOの役割
この開発は、チップレットパッケージング技術の多様化を浮き彫りにしています。TSMCのCoWoS(シリコンインターポーザーを使用)が市場の最高級セグメントを支配している一方で、AmkorのHDFOは、高帯域幅を必要とするが、シリコンインターポーザーの極端なコストと供給制約に敏感なアプリケーション向けに、スケーラブルな代替手段を提供します。HDFOの立ち上げの成功は、有機RDL技術を使用した「2.5Dライク」な性能が、チップレット向けの主流プロセスになりつつあることを裏付けています。Amkorのこの戦略は、AIの普及に伴う半導体パッケージング市場の多様なニーズに応える上で、重要な役割を果たすでしょう。
元記事: https://finviz.com/news/325397/amkors-hdfo-ramp-accelerates-is-the-growth-thesis-strengthening









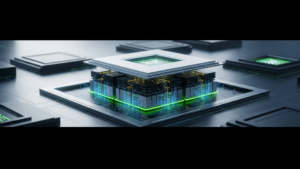
コメント