AI駆動型のパッケージング変革の背景
この記事は、最近のカンファレンスでの洞察を統合し、「AI駆動型」のパッケージングシフトについて論じています。AI GPU用のインターポーザーサイズが増加し(複数のレチクルサイズに近づく)、標準的な300mmウェハで生産できるチップの数が劇的に減少することで、膨大な無駄とコスト非効率が生じるという議論を展開しています。この幾何学的な制約が、業界がパネルレベルパッケージング(PLP)へ移行する主要な原動力となっています。例えば、600mm x 600mmのパネルは、300mmウェハの5.7倍の面積を持ち、キャリア面積効率を45%(ウェハ)から81%(パネル)へと潜在的に向上させることが可能です。これにより、大規模AIチップの生産性が大幅に改善される見込みです。
主要な技術ロードマップと効率性の向上
レポートは、特定の技術ロードマップを強調しています。TSMCが2027年を目標としている「CoPoS」(Chip-on-Panel-on-Substrate)を、Nvidiaの「Rubin Ultra」のような巨大AIチップと関連付けて言及しています。また、より少量生産のUHD(Ultra High Density)FOPLPは、ASEやPowertech Technology(PTI)などのOSATsによって、より早い時期(2025年下半期/2026年)に生産が開始されると指摘しています。これらの技術は、長方形パネルを使用することでウェハに比べてはるかに効率的な材料利用が可能となり、大規模なダイを多数処理する際のコストメリットが大きいため、特にAI向けパッケージングで注目されています。
ガラスコア基板への材料移行と今後の展望
さらに、この記事は、大型有機パネルに内在する反り問題を解決するためのガラスコアへの材料移行について議論しています。ガラスは並外れた寸法安定性を提供し、次世代チップレットが必要とするより微細なライン/スペース(L/S < 2/2 μm)の配線を可能にします。PLP(規模のため)とガラスコア(性能のため)の融合は、2026年以降のパッケージングの決定的な将来の方向性として提示されています。この技術的な収斂は、AIチップの性能を最大限に引き出し、同時に製造コストを抑えるための鍵となります。ガラスコア技術は、より複雑で高性能なチップレット統合を可能にし、半導体産業の新たな成長を牽引するでしょう。









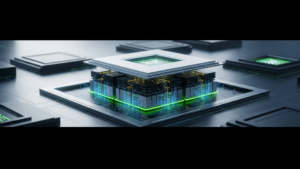
コメント