先進パッケージングにおける洗浄の課題
ウェハ処理ソリューションのサプライヤーであるACM Researchは、パネルレベルプロセスへの業界の移行を示す重要なパッケージング装置の受注を獲得しました。特に注目すべきは、パネルレベル真空洗浄システム「Ultra C vac-p」です。この装置は、FOPLPにおける重要な課題、すなわち、超微細バンプピッチ(40ミクロン未満)と低いスタンドオフハイトを持つ大型ダイの下からフラックス残渣を除去するために特別に設計されています。従来の洗浄方法は、表面張力のために、高度なチップレットアセンブリの狭い隙間に浸透するのが困難でした。フラックスが除去されないと、最終的なパッケージにボイドが発生し、信頼性障害につながる可能性があります。
Ultra C vac-pの技術的特長
ACMの技術は、真空圧を利用して洗浄液をこれらの隙間に強制的に送り込み、アンダーフィルプロセスの前に完全に残渣を除去することを可能にします。これにより、複雑な多層パッケージの信頼性と歩留まりが大幅に向上します。このツールは、510x510mmや600x600mmを含む複数のパネルサイズをサポートしており、有機基板とガラス基板の両方に対応可能です。これは、パネルレベルパッケージングの多様な要求に応える柔軟性を示しており、将来的な材料やパッケージング技術の進化にも対応できる設計となっています。真空洗浄技術は、微細化が進む先進パッケージングにおいて不可欠な要素です。
受注の意義と業界への影響
「中国本土以外の主要なグローバル半導体パッケージングメーカー」(業界の状況から台湾または東南アジアに拠点を置く企業と推測されます)からのこれらの受注は、2.5Dおよび3D統合におけるパネルベース製造への移行が加速していることを裏付けるものです。これは、チップレット時代をサポートするためには、リソグラフィやボンディングツールだけでなく、洗浄、エッチング、めっきなどのプロセス制御装置も進化しなければならないことを強調しています。これらの先進的な洗浄装置の導入は、歩留まり向上と信頼性確保に大きく貢献し、AIチップなど高性能半導体の量産体制を支える上で不可欠な要素となります。この動きは、半導体製造サプライチェーン全体の技術革新の重要性を示しています。









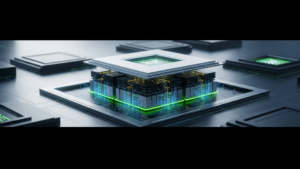
コメント